xLight获4000万美元融资,加速EUV自由电子激光器开发
当地时间2025年7月22日,美国极紫外(EUV)光源技术开发商 xLight 宣布已完成超额认购的 B 轮股权融资,融资额达4000万美元。
据介绍,该轮融资由早期风险投资公司 Playground Global 领投,投资于在前沿技术方面取得突破的企业家,Boardman Bay Capital Management 也跟投,Boardman Bay Capital Management 是一家领先的投资管理公司,专门研究变革性技术子行业的高增长机会。Morpheus Ventures、Marvel Capital 和 IAG Capital Partners 也加入了本轮融资。
这笔资金进一步使xLight能够开发出世界上最强大的EUV自由电子激光器(EUV-FEL),这将彻底改变先进的半导体制造,并解锁其他关键的经济和国家安全应用。

xLight 首席执行官兼首席技术官 Nicholas Kelez 说:“xLight的使命是为半导体制造打造一种变革性的新型光源,以解决当今行业面临的关键挑战——成本、功能和容量。本轮融资将为公司提供完成详细设计和启动我们全尺寸原型机建设所需的资金。 先进半导体制造正接近一个关键的转折点——与我们在国家实验室和半导体生态系统中的合作伙伴一起,在投资者的支持下,我们将实现自由电子激光器的商业化,并帮助重新夺回美国在半导体制造领域的领导地位。”
xLight 董事会执行主席兼 Playground Global 普通合伙人 Pat Gelsinger 说:“xLight 代表了一个千载难逢的机会,可以恢复美国在支撑半导体行业最关键技术之一方面的领导地位。通过提供比现有技术改进十倍的节能 EUV 激光器,xLight 有潜力推动摩尔定律的下一个时代——保持芯片扩展的活力,提高晶圆厂的生产力,并将这一基础能力锚定在美国供应链中。”
xLight表示,将继续执行其业务目标,与康奈尔大学加速器科学与教育实验室 (CLASSE)、洛斯阿拉莫斯国家实验室 (LANL) 和费米国家加速器实验室的持续合作伙伴关系证明了这一点,这三个全球公认的领先研究机构。在过去的两年里,该公司完成了关键系统设计,包括子系统原型设计和首件产品,并与 ASML 的技术负责人建立了工作关系。
xLight 与 CLASSE 的合作主要集中在研发上,最终目标是将康奈尔大学 BNL ERL 测试加速器 (CBETA) 开发的技术商业化。与 LANL 的合资企业由新墨西哥州 TRGR 技术准备计划资助,专注于应用现代机器学习技术来实现大型加速器的自动化。像 LANL 合作开发的大型加速器是 xLight 技术路线图中不可或缺的组成部分。该公司与费米实验室的合作重点是超导射频腔和低温模块的开发和测试——这两项实验室几十年来掌握的粒子加速器技术。
EUV-FEL光源有何优势?
目前光刻机巨头ASML的EUV光刻机所采用的是EUV光源系统,正是基于被称为激光等离子体EUV光源(LPP),其原理是通过30kW功率的二氧化碳激光器轰击以每秒50000滴的速度从喷嘴内喷出的锡金属液滴,每滴两次轰击(即每秒需要10万个激光脉冲),将它们蒸发成等离子体,通过高价锡离子能级间的跃迁获得13.5nm波长的EUV光线。
但是,正式由于EUV-LPP系统需要依靠功率强大高能激光脉冲来蒸发微小的锡滴(在 500,000ºC 下),使得其整个光源系统不仅庞大复杂,且功耗巨大,所产生的EUV光源的功率也有限,这也是导致当前EUV光刻机成本高昂的一大原因。目前全球仅有头部的少数的晶圆制造厂商能够用的其这种单价高达约1.5亿美元的EUV光刻机,主要用于7nm以下的先进制程芯片的制造。值得一提的是,该系统发射极紫外光的同时会产生碎屑而污染集光镜。
近年来,美国、中国、日本等国家的研究机构为了都有在研发新的基于直线电子加速器的自由电子激光(FEL)技术的EUV光源系统,希望绕过ASML所采用的EUV-LPP技术路线,大幅降低EUV光源的系统的成本。其中,基于自由电子激光器(FEL)技术的EUV光源方案被寄予厚望,目前该技术大致分为两种类型:振荡器FEL和自放大自发辐射(SASE)FEL。
在振荡器FEL中,来自电子加速器的电子束在波荡器中发光,与存储在振荡器中的波荡器光相互作用,并放大FEL光。然而,由于镜面对短波长光的反射率较差,FEL波长被限制在100nm以上;在SASE-FEL中,加速器提供的高质量电子束的自发辐射在长波荡器中自放大,无需任何振荡器和外部种子。它适用于短波长FEL,例如EUV-FEL,这也是目前研究的主要方向。
而用于SASE-FEL的直线加速器(linacs)也分为两种:正常传导和超导直线加速器。
正常传导直线加速器很常见,但其电子束的平均电流被限制在小于∼100 nA,以避免直线加速器腔因高热负荷而变形。而超导直线加速器由于热负荷极低而具有更高的束团重复频率和平均电流(通常为几十μA),因此更适合高功率的自由电子激光器。
如果与没有能量回收功能的普通直线加速器相比,拥有能量回收直线加速器(ERL)是更强大的自由电子激光器驱动器。基于ERL 的 EUV-FEL 可成为最强大的 EUV 光源,通过使用能量回收方案和超导加速器技术来克服 EUV 光刻的当前问题。
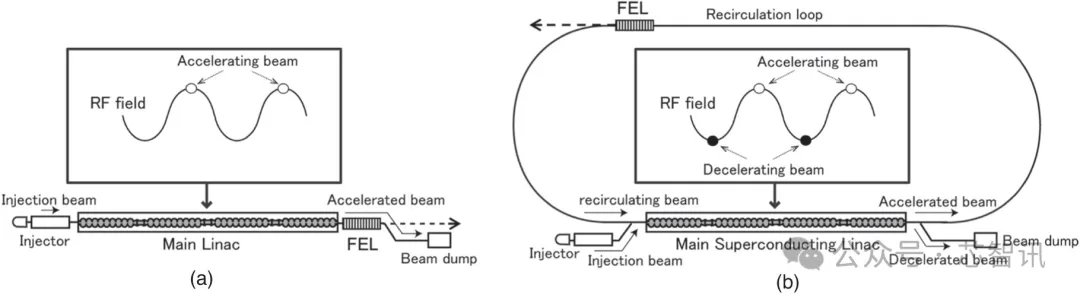
△(a) 普通直线加速器 和 (b) 能量回收直线加速器示意图。
与激光等离子体EUV光源(EUV-LPP)相比,基于ERL 的EUV-FEL 光源具有多项优势:EUV-FEL 光源可产生超过 10 kW 的高 EUV 功率,且不会产生锡滴碎片,因此,它可以同时为 10 台EUV光刻机供超过1000W 的 EUV 功率,而不会对 Mo/Si 反射镜面造成锡污染。
系统及运营成本可降低3倍
根据此日本筑波的高能加速器研究组织(KEK)的研究人员公布的基于EUV-FEL光源的研究论文显示,EUV-FEL光源的建设和运行成本粗略估计为10kW EUV功率4亿美元和每年4000万美元的运营成本,因此1kW EUV功率建设成本约4000万美元和每年400万美元。相比之下,通过简单的线性外推,LPP光源的建设和运行成本粗略估计为250W EUV功率2000万美元和每年1500万美元,即每1kW EUV功率建设成本为8000万美元和运行成本为每年6000万美元。
显然,EUV-LPP光源的建设成本达到了EUV-FEL光源建设成本的2倍,运营成本更是达到了其15倍。综合来看,EUV-LPP光源的成本也达到了EUV-FEL光源的3倍。这其中,集光镜的维护费用占了运营成本的大部分,因为集光镜会因锡碎屑的污染而老化,需要经常更换。另外庞大的能源消耗也是一大成本。也就是说,采用EUV-FEL光源来代替EUV-LPP光源,综合成本可以降低2倍以上。
帕特基辛格加入的xLight公司所研发的的正是基于ERL 的EUV-FEL 技术路线的EUV光源系统。根据官网资料显示,xLight 由一支由光源先驱、光刻师和粒子加速器制造商组成的团队领导。虽然规模很小,但其团队在光刻和加速器技术领域拥有多年的经验,不仅拥有来自斯坦福直线加速器和其他地方的粒子加速器资深研究人士,其首席科学家 Gennady Stupakov 博士还是 2024 年 IEEE 核能和等离子体科学学会粒子加速器科学技术奖 (PAST 奖) 的两名获奖者之一。
根据刚刚出任xLight执行董事长的帕特·基辛格发布的文章显示,xLight 研发的LPP EUV光源系统,其功率也达到了当今最先进EUV光源系统的四倍,即1000W左右,并且到 2028 年将准备好用于商业化应用。
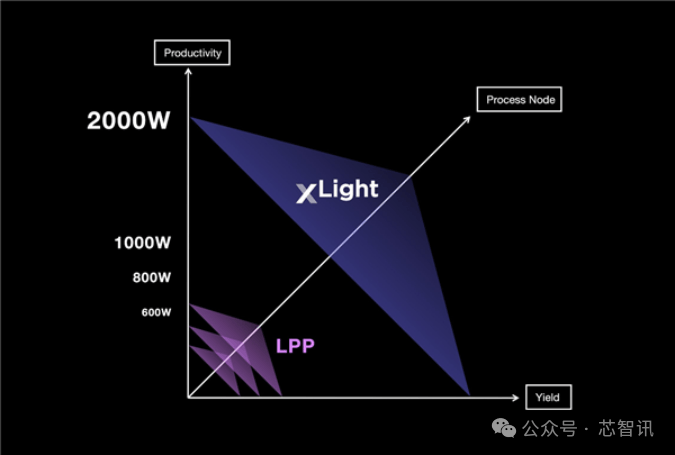

资料显示,ASML 的 Twinscan NXE:3600D 具有 250W LPP EUV光源源,而 NXE:3800E 配备了300W EUV-LPP光源。虽然 ASML 已在研究环境中证明其EUV-LPP光源功率可以超过 500W,但这些更高的功率水平尚未在商业部署的系统中提供。然而,ASML 依然在继续致力于提高其EUV-LPP光源功率,并计划将其提高到600W甚至是1000W以上。
xLightg通过官网指出,LPP-EUV 是目前为尖端半导体制造生产 EUV 光的唯一方法。然而,它非常耗电(约1.5 MW 的电力仅产生 500 W 的光),并且无法完全支持 ASML 光刻机的当前和未来版本,这些版本需要高达 2 kW 的电源。
帕特·基辛格声称,xLight 的技术可以提供当前EUV光源4倍的功率(1000W),可以将每片晶圆的光刻成本降低约 50%,并且单个 xLight 的EUV-FEL光源系统可以支持多达 20 台 ASML EUV光刻机使用,光源系统的使用寿命为 30 年,可以将资本和运营支出减少 3 倍以上,这将是制造效率的重大飞跃。
虽然有资料显示 ASML 的 Twinscan NXE:3800E 的大致价格(约 2.4 至 2.5 亿美元),但我们难以以此来猜测光源系统的成本。但是,如果xLight 的 EUV-FEL光源系统可以将资本支出和运营成本降低至原来的1/3,这可能意味着与当今 ASML 的EUV光刻机相比,基于 FEL EUV光源系统的EUV光刻成本将大幅降低。
需要注意的是,xLight 的目标并不是取代 ASML 的 EUV 光刻工具,而是推出一个可以兼容ASML EUV光刻机的EUV-LPP光源系统,实现“到 2028 年将连接到 ASML 光刻机并制造晶圆”。但目前尚不清楚,xLight 的LPP EUV光源系统是否会兼容ASML High NA EUV系统,但是据现有的信息来看,ASML的High NA EUV光刻机依然是基于EUV-LPP技术路径,因此是有望实现兼容的。
xLight 称,其成立的使命是打造一种能够彻底改变光刻、计量和检测的光源。之所以有这个目标,是源于“美国必须重新夺回并保持半导体制造业的领导地位”这样的信念。xLight 利用数十年的投资和美国在粒子加速器技术、基础设施和知识方面的领导地位,正在快速开发和部署其独特的EUV-FEL光源解决方案,以实现更经济、更可持续的 EUV 光刻未来。在此基础上,xLight 设计了一个具有新功能的 HVM(大批量制造)兼容系统,该系统可提供生产力和性能,从而推动尖端半导体制造业数十年的持续进步。
虽然EUV-FEL光源相比EUV-LPP光源拥有着很多的优势,但是其也面临着体积庞大,难以融入现有的晶圆制造洁净室的问题,比如在现有标准低EUV光刻机当中,光源位于机器本身的下方,而对于High NA EUV设备,其EUV-LPP 光源位于同一水平面上,因此任何“第三方”光源系统都必须考虑到这些事实,如果EUV-FEL光源被证实具有商业化价值的话,或许EUV-FEL光源将会融入下一代晶圆厂的设计考虑当中。
值得注意的是,ASML在十年前曾考虑转向EUV-FEL光源,近年也在将EUV-FEL光源的技术进展与EUV-LPP光源技路线图进行比较时,再次考虑转EUV-FEL光源。但最终,ASML公司高管认为EUV-LPP光源带来的风险较小。
编辑:芯智讯-浪客剑
