YOLE:AI撬动81亿美元CPO市场
C114讯 6月17日消息(水易)市场研究机构YOLE Group在最新报告中表示,人工智能的迅猛发展,尤其是大语言模型和生成式AI的兴起,正在推动共封装光学器件(CPO)的广泛应用。AI工作负载对高带宽、低延迟和能效提出了更高要求,以连接超大规模数据中心或“AI工厂”中的百万个GPU。关键驱动力包括数据传输需求、能源效率、可扩展性以及行业投资。
在横向扩展(scale-out)网络中,CPO能够实现长距离、高带宽的连接(例如机架之间),具备更低的延迟和功耗,非常适合用于AI驱动的云网络架构以及以太网/InfiniBand网络。可插拔光模块将在计算节点上继续使用,直到CPO技术更加成熟。
在纵向扩展(scale-up)网络中,CPO 取代了铜缆,提供更佳的连接性能、更远的传输距离和更低的功耗,对于GPU间或节点与交换机之间的互连至关重要,尤其是在AI训练和高性能计算(HPC)场景中。
初期的CPO部署将首先聚焦于scale-up网络,随后再向scale-out网络扩展。
2025年GTC大会上,英伟达发布了Spectrum-X和Quantum-X硅光子交换芯片,标志着CPO在AI基础设施中的应用迈出了重要一步。这些交换机使用 CPO 连接具有 1.6Tbps 端口的 GPU。英伟达在其Rubin架构中采用CPO技术,突破了NVLink的限制,实现了更快、更具扩展性的低功耗互连。
YOLE表示,CPO市场价值在2024年为4600万美元,预计到2030年将达到81亿美元,复合年增长率高达137%。这一增长主要由从可插拔光模块向CPO、以及从铜缆向光通信的转变所驱动,旨在应对功率、密度、可扩展性、带宽和传输距离等方面的挑战。

CPO将光模块与交换机ASIC或处理器集成在一起,从而在scale-out(云网络架构)和scale-up(AI/GPU集群)网络中实现高带宽、低功耗的互连。CPO供应链涵盖半导体晶圆厂、光电子制造商、封装服务商和光纤厂商等多个环节(如下图)。

CPO利用光子集成电路(PIC)结合激光器、调制器和波导,实现高效的光电信号转换。scale-out网络使用标准化的PIC以支持低成本的以太网交换机,而scale-up网络则依赖定制化的PIC来实现如NVLink这样的高容量AI互连接口,并通过PAM-4或NRZ调制技术实现每秒数万亿比特的吞吐量。基于台积电5nm和3nm工艺的交换机ASIC则确保了高效的数据路由。
光子封装方面,主要采用2.5D(在同一基板上并排放置)或3D(通过通孔或EMIB堆叠)技术。2.5D方案具有高密度互连和结构简单的优势,但面临可扩展性和散热方面的挑战;3D方案则减少了占用空间并降低了功耗,但制造复杂度更高。ASIC/光子小芯片边缘的带宽密度是关键,光子中介层支持堆叠小芯片的2D光学I/O,从而提高密度,减少延迟,并简化 HPC和数据中心的集成。
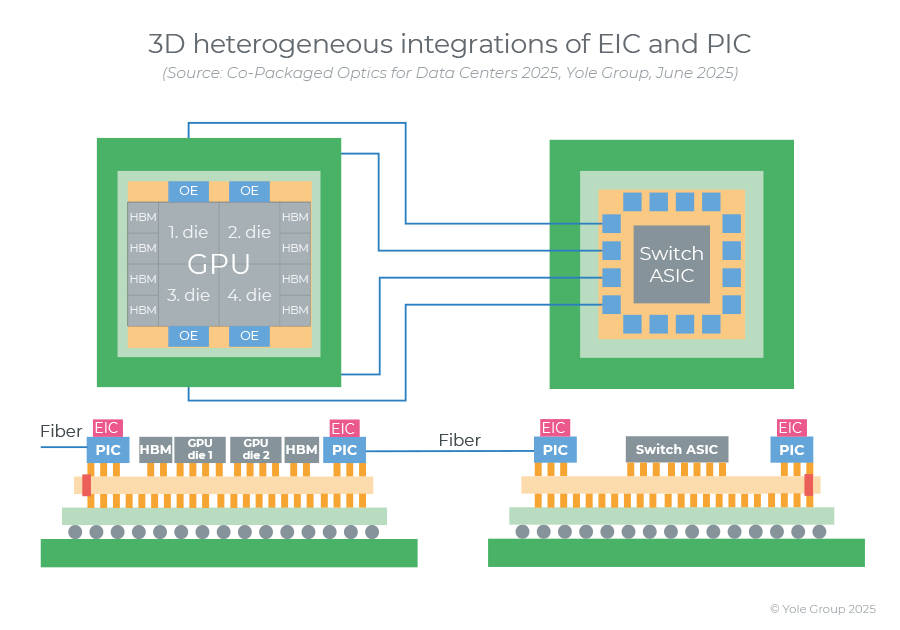
YOLE认为,CPO不断发展以满足AI需求,scale-out侧重于成本和规模,而scale-up则专注于性能和定制化,正在变革数据中心的连接方式。与此同时,由AI驱动的CPO正在重塑数据中心架构,英伟达、博通和台积电等企业引领这一趋势。
